团队开发出检测晶体管缺陷的灵敏新方法
作者:admin 来源:本站 发布时间:2022-06-07 访问量:3815

美国国家标准与技术研究院 (NIST) 的研究人员及其合作者设计并测试了一种新的、高度灵敏的检测和计数晶体管缺陷的方法——这是半导体行业在为下一代开发新材料时迫切关注的问题。设备。这些缺陷会限制晶体管和电路的性能,并会影响产品的可靠性。
对于大多数用途,典型的晶体管基本上是一个开关。当它打开时,电流从半导体的一侧流向另一侧;关闭它会停止电流。这些动作分别创建了数字信息的二进制 1 和 0。
晶体管的性能关键取决于指定电流量的可靠程度。晶体管材料中的缺陷,例如不需要的“杂质”区域或断裂的化学键,会中断和破坏流动。这些缺陷可能会在设备运行时立即显现或在一段时间内显现出来。
多年来,科学家们已经找到了多种方法来对这些影响进行分类和最小化。
但随着晶体管尺寸变得几乎难以想象且开关速度非常高,缺陷变得更难识别。对于一些正在开发的有前途的半导体材料——例如碳化硅 (SiC) 而不是单独用于新型高能、高温器件的硅 (Si)——还没有简单直接的方法来详细表征缺陷。

NIST 的 James Ashton 说:“我们开发的方法适用于传统的 Si 和 SiC,这使我们第一次不仅可以通过简单的直流测量来识别给定空间中的缺陷类型,还可以识别缺陷的数量。”与 NIST 和宾夕法尼亚州立大学的同事进行的研究。他们于 10 月 6 日在《应用物理学杂志》上发表了他们的研究结果。该研究侧重于晶体管中两种电荷载流子之间的相互作用:带负电的电子和带正电的“空穴”,即局部原子结构中缺少电子的空间。

当晶体管正常工作时,特定的电子电流会沿着所需的路径流动。(空穴也可以形成电流。这项研究探索了电子电流,这是最常见的排列方式。)如果电流遇到缺陷,电子会被捕获或移位,然后可以与空穴结合形成电中性区域,这个过程称为重组。
每次复合都会从电流中移除一个电子。多种缺陷会导致电流损失,从而导致故障。目标是确定缺陷的位置、它们的具体影响,以及理想情况下的缺陷数量。
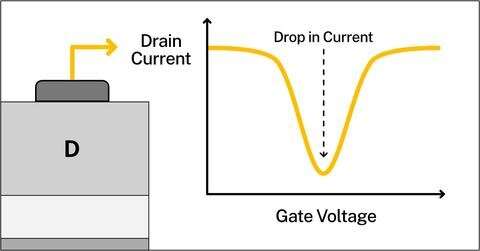
“我们希望为制造商提供一种在测试不同新材料时识别和量化缺陷的方法,”NIST 的合著者 Jason Ryan 说。“我们通过创建一个缺陷检测技术的物理模型来做到这一点,这种技术一直被广泛使用,但迄今为止人们对其了解甚少。然后我们进行了原理验证实验,证实了我们的模型。”
在经典的金属氧化物半导体设计(见图)中,称为栅极的金属电极放置在薄绝缘二氧化硅层的顶部。在该界面下方是半导体的块体。
门的一侧是输入端,称为源极;另一个是输出(漏极)。科学家通过改变施加在栅极、源极和漏极上的“偏置”电压来研究电流的动态变化,所有这些都会影响电流的移动方式。
在这项新工作中,NIST 和宾夕法尼亚州立大学的研究人员专注于一个通常只有约十亿分之一米厚和百万分之一米长的特定区域:薄氧化层和体半导体之间的边界或通道身体。
“这一层非常重要,因为电压对晶体管氧化物顶部金属的影响会改变氧化物下方沟道区域内的电子数量;该区域控制着器件从源极到漏极的电阻, ”阿什顿说。“这一层的性能取决于存在多少缺陷。我们研究的检测方法以前无法确定这一层中有多少缺陷。”
一种检测通道缺陷的灵敏方法称为电检测磁共振 (EDMR),其原理与医学 MRI 类似。质子和电子等粒子具有称为自旋的量子特性,这使它们的作用类似于具有两个相反磁极的微小条形磁铁。在 EDMR 中,晶体管被微波照射的频率大约是微波炉的四倍。实验者向设备施加磁场,并在测量输出电流的同时逐渐改变其强度。
在频率和场强的正确组合下,缺陷处的电子“翻转”——反转它们的极点。这会导致一些损失足够的能量,以至于它们与通道缺陷处的空穴重新结合,从而降低了电流。然而,通道活动可能很难测量,因为大量的“噪声”来自半导体主体中的重组。
为了专注于通道中的活动,研究人员使用了一种称为双极放大效应 (BAE) 的技术,该技术通过将施加到源极、栅极和漏极的偏置电压安排在特定配置中来实现(见图)。“因此,由于我们在 BAE 中使用了偏置,并且因为我们测量了漏极的电流水平,”Ashton 说,“我们可以消除晶体管中发生的其他事情的干扰。我们可以只选择我们关心的通道内的缺陷.”
BAE 运作的确切机制直到该团队开发其模型才为人所知。“唯一的测量结果是定性的——也就是说,他们可以判断通道中的缺陷种类,但不能判断数量,”共同作者、宾夕法尼亚州立大学工程科学与力学杰出教授帕特里克·勒纳汉说。
在 BAE 模型之前,该方案被严格用作为 EDMR 测量施加电压和控制电流的资源,这对于更定性的缺陷识别很有用。新模型使 BAE 成为定量测量缺陷数量的工具,并且仅通过电流和电压进行测量。重要的参数是界面缺陷密度,它是一个数字,描述了半导体-氧化物界面的某个区域内有多少缺陷。BAE 模型为研究人员提供了 BAE 电流如何与缺陷密度相关的数学描述。
研究人员在一组金属氧化物半导体晶体管的概念验证实验中测试了该模型,使定量测量成为可能。“现在我们可以解释整个通道区域中电荷载流子分布的变化,”Ashton 说。“这开辟了可以通过简单的电气测量进行测量的可能性。”
“这项技术可以提供对这些不稳定晶体管缺陷的存在的独特见解,并提供对其形成机制理解的途径,”前英特尔公司、现任半导体计量学高级主管和理学研究员Markus Kuhn 说,他没有参与这个调查。“有了这些知识,将有更大的机会控制和减少它们,以提高晶体管的性能和可靠性。这将是进一步增强芯片电路和器件性能设计的机会,从而产生更好的产品性能。”

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学