氧是直拉(CZ)硅单晶中最主要的杂质,氧是在晶体生长过程中被引入的,在随后的器件制造工艺过程中,由于硅晶体经历了各种温度的热处理,过饱和的间隙氧会在硅晶体中偏聚和沉淀,形成了氧施主、氧沉淀及二次缺陷。直拉硅单晶中的氧来自晶体生长时石英坩埚的污染。当多晶硅熔化成液相时,液态硅在高温下严重侵蚀石英坩埚。

氧在硅晶体中的分布,不受晶体生长方向的影响,但会受到液态硅里的氧浓度和晶体生长炉内的热场的影响,除此之外,氧的分凝起着重要的作用。氧的分凝系数可以用区熔和直拉的方法测量,氧在硅中的平衡分凝系数K0为1.25。氧浓度沿直拉硅晶体生长方向的分布,从图中可以看出,氧在晶体锭头部浓度高,在晶体锭尾部浓度低,氧浓度从晶体头部到尾部逐渐降低,而晶体锭的头部是最先凝固的,由此证实,硅中氧的平衡分凝系数应大于1.0。
和硅中掺杂杂质相比,氧是一种快速扩散杂质。当含氧硅材料在高温热处理时,体内的氧会发生扩散,产生氧原子的偏聚;同时,氧还会向硅材料外扩散。当区熔硅材料在氧气氛中高温热处理时,氧原子也能从表面向体内扩散。对氧而言,它在体内的扩散系数和向体外的扩散的扩散系数是相同的,说明氧从体内向外扩散,和氧从表面向内扩散的机理是一样的。在700℃以上高温和400℃ 以下低温,实验值和扩散系数表达公式的理论曲线吻合得很好,但是,在400~700℃左右的温度范围内,没有实验值支持这个公式。这是因为在此温度区间,氧产生异常扩散,形成与有关的施主团,其实际扩散系数远远大于理论估计值。研究者认为,之所以在此温度范围扩散很快,是因为它并不是像在高温时一样以间隙形式扩散的,而是形成一种特殊的扩散体结构,在硅晶格中快速扩散。

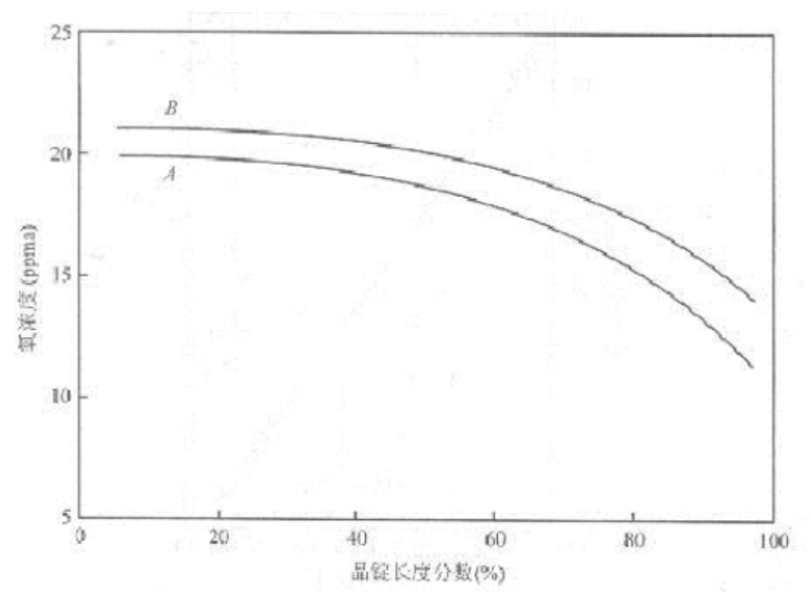


 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学