半导体产业群雄激战先进封装技术
作者:admin 来源:本站 发布时间:2021-07-05 访问量:1274
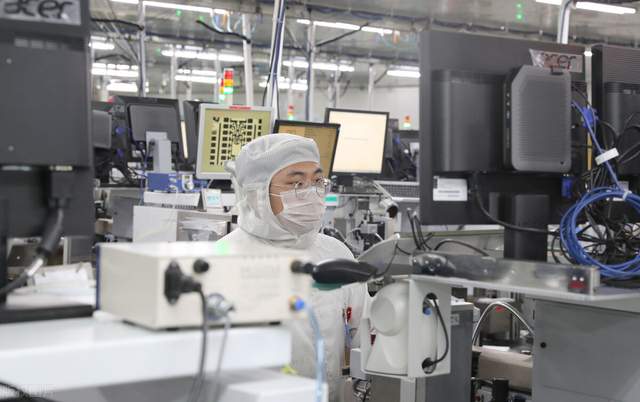
尽管时序已进入2021年,但半导体产业界知名的「摩尔定律」(Moore's Law),现阶段仍是主宰全球积体电路应用板块市场、工程制造厂商,不断往前、推进的最主要驱动力。
传统而言,摩尔定律建构于制程微缩技术,随着各家晶圆制造厂(IDM、Foundry)不断向前推进更微缩、更高阶制程的结果,单位芯片面积上的晶体管数量,每二年理应呈现倍增结果;由1965到2021年,共长达66年来推算,电晶体今日的数量应该可以增长达86亿颗,此与苹果(Apple)最新智慧型手机iPhone 12的应用处理器(Application Processor :AP)—A14,电晶体数量达118亿颗相去不远。
效能、功耗、面积、价格芯片超越摩尔定律四大关键
不过,单凭制程微缩,已经无法符合传统摩尔定律所预期的效能提升要求,取而代之的是超越摩尔定律(More than Moore) ,一颗芯片所需考量者,已不再仅止于关注电晶体的关键尺寸与数量,更包含:PPAC四个项目——即Performance(效能)、Power(功耗)、Area(晶片面积)、Cost(价格)。
为了倍增单位IC芯片面积上的晶体管数量,电晶体设计的标准单位高度,因此也跟着微缩制程。在封装制程上,更由传统封装制程,转变成先进的2.5D、3D异质整合封装制程,大大提升晶片效能,但同时,也因此增加封装制程的工艺技术复杂度。
为了让运算资料不须因为频繁地进出微处理器,而浪费了资料传递时间与运作功耗,电脑架构方面则引进了记忆体内运算(in-memory computing;IMC)概念,提升微处理器晶片运算效能。
过去将近半个世纪以来,全球产业界IC逻辑制程的研发历程,由最初的垂直整合制造大厂(IDM)英特尔(Intel)独领风骚;90年代,多家争鸣、竞争白热化,市场竞争同业积极挑战英特尔不可动摇的霸主地位,经过多年的市场竞争、优胜劣败汰除后,近几年最后又定于一尊。
尽管逻辑制程的产业竞争稍有止歇,但另一块更加激烈的竞争战场—开发先进封装技术,多年前早已展开,各家国际晶圆制造大厂(IDM、Foundry),都有自行研发的制程解决方案,并已陆续实现于旗下高阶代工服务产品中。
例如:英特尔提出的Foveros与嵌入式多芯片互连桥接(Embedded Multi-Die Interconnect Bridge;EMIB)、韩国三星电子(Samsung)提出的整合式叠层封装(Integrated Package-on-Package;iPOP)与扇出型面板级封装(Fan-Out Panel Level Packaging;FOPLP) & FOPLP-PoP,以及台积电(TSMC,2330)提出的3D Fabric平台(包含SoIC、InFO、CoWoS…等等)。
半导体产业创新靠先进封装能否向前推进是成败关键
发展速度逐渐加快的全球「先进封装」市场,正持续吸引着半导体供应链各板块领域巨擘,包括:台积电(TSMC)、英特尔(Intel)、三星(Samsung)、安可(Amkor)、日月光(ASE )等不同领域的半导体巨擘,活跃于该市场,充分把握市场发展价值。先进封装技术目前已经成为半导体产业创新、向前再推进的重要关键,继续推动产业参与者探索新领域,同时也进一步成为弥合IC芯片、PCB之间发展差距的重要关键。
先进封装技术发展,现阶段正从原本的封装基板平台应用,逐渐转移至IC晶片间整合封装的更高阶技术层次,这一产业发展转变,正好为台积电、英特尔、三星等半导体巨擘,提供展示其技术实力的最佳机会平台,同时也助益它们成为全球半导体产业,新世代先进IC封装技术的领先群。特别于开发创新先进封装平台——自原本的扇出型(InFO)封装,到2.5D Si中介层(CoWoS),直至3D SoIC阶段,台积电已经成为上述几个领域的主导大厂。
成长最快的先进封装平台3D/2.5D堆叠和扇出
先进IC封装制程,目前已成为全球半导体产业持续创新、向前推进发展的重要关键,对于缩短IC芯片、PCB二者间,立体堆叠制程的物理间距,相当重要。
半导体产业正持续开发可应用于微缩技术蓝图、功能蓝图的新世代产品,尽管目前整体市场上,仅剩三家主要、大咖的半导体晶圆制造厂参与者,而且制程微缩步调似已出现放缓迹象,但制程微缩发展蓝图,预料仍可望延续至七纳米以及更高阶先进制程。
就实现功能蓝图的规划目标而言,使用晶圆制造商的异质整合技术,并搭配先进IC封装技术的强力奥援,将因此变得更为重要。确实,先进的半导体IC封装技术,可以透过增加功能性以及持续提高性能,同时透过降低成本的方式,进一步增加半导体产品价值。
就IC芯片制程应用的高阶、低阶市场上,产业界正积极针对消费者需求、性能、专门应用等领域,开发各种多晶片封装,如系统级封装(SiP)、2.5D Si中介层(CoWoS )封装、扇出型(InFO)封装,这些不同封装制程的应用,将可满足与异质IC芯片整合所需具备的相关功能性,以及更快的上市时间等客户下单需求。
就各种先进IC封装技术而言,覆晶封装(flip-chip,FC)于2019年时,约占全球整体市场营收83%比重。但是,预估到2025年时,其市占率将进一步下滑至约77%;但3D堆叠、扇出型封装技术市占率,则将从2015年时成长5%,至2025年时,进一步分别成长达10%、7%。3D堆叠、扇出型封装技术,将持续分别以令市场人士印象深刻的21%、16%速度成长,稳步提高其于各种应用中的获得采用比率。
全球半导体3D IC堆叠市场的成长,主要由3D记忆体——高频宽记忆体(HBM)、3D DDR DRAM、基于2.5D中介层的裸芯片区和异质整合、3D NAND和堆叠型CIS、Foveros、3D SoC等封装技术所带动。
因受惠于不同商业模式新进业者的加入市场,整体扇出型封装市场预料也将有望出现强劲成长。
扇入式晶圆级封装(WLP)技术市场,主要由移动设备应用所主导,2019年至2025年期间,CAGR为3.2%。嵌入式晶片尽管市场规模较小,但预计未来五年内,受惠于电信及基础设施、汽车和行动装置应用市场的同步带动下,CAGR将可达18%。
「SoIC」制程「难度」挑战大台积电表现市场有目共睹
台积电「SoC先进封装制程」,目前应用、下单代工、出货量规模最大的客户、代工产品者,为苹果(Apple)的「A14 Bionic SoC」AP处理器。从Apple所公开的硬件相关资讯内容,以及其它已公开发表的分析技术文章中可以得知,此颗「SoC」主要包含一颗台积电最新5纳米制程节点的应用处理器(A14 Bionic AP) ,以及四颗由韩国三星制造共6GB的LPDDR4X记忆体(K3UHCHC0MM-VGCL RAM),「SoC封装制程」则采用台积电所开发的「InFO_PoP」先进IC整合封装技术。
2019年第二季时,台积电已领先完成全球首颗「3D IC」封装芯片,当时即预计将于2021年正式量产。
台积电近几年所推出「CoWoS」IC晶片封装架构,以及「整合扇出型」封装制程等,原本就是为了透过IC芯片的堆叠工艺、封装制程,摸索「后摩尔定律」时代的制程推演路线,真正的3D封装制程技术出现后,更进一步强化台积电「垂直整合服务」市场竞争力。
尤其未来「异构芯片」的整合堆叠制程,将会是重要应用趋势。晶圆制造厂将处理器(CPU)、高频记忆体、CMOS 影像感应器、微机电系统、数据芯片等IC芯片封装在一起,有助于提升包含处理器在内的运算模组的运算效率,而先前的IC芯片封装制程技术,只能概称为「2.5D」。
未来,于IC晶片制程封装不同工艺制程的晶片,将会发展成相当大的市场需求规模,使得半导体供应链的上下游串联,更势在必行。所以连原本身为IC晶圆代工厂的台积电,也须积极投入后端的半导体IC封装高阶、先进技术,预计日月光、矽品等原本的封测大厂,也将加速布建3D IC高阶封装制程的技术、产能。
不过,这并不是容易达成、快速量产的IC封装制程技术,需要搭配困难度更高的制作工艺,如硅钻孔(TSV)技术、导电材质填孔、晶圆薄化、晶圆连接及散热支持等,料将因此进入新一轮技术资本竞赛。
截至目前为止,台积电运用硅钻孔(TSV)技术、导电材质填孔、晶圆薄化、晶圆连接及散热支持等高阶、先进「SoIC」封装工艺技术的能力,相当地突出、卓越,也因而成功造就、取得了「SoC先进封装制程」良率&量产规模,领先市场竞争同业的强大优势。
全球先进封装市场动能强五年内将达传统封装三倍
全球半导体供应链的所有参与厂商,目前正大力推动「先进封装(Advanced Packaging;AP)」业务发展。
虽然因为受到COVID-19的影响,造成2020年全球先进封装市场规模,预期将较前一年同期下滑6.8%。不过,Yole半导体、记忆体&运算事业部总监Emilie Jolivet表示,「我们仍非常乐观地坚信这一市场将在2021年反弹,并较同期成长约14%。」
Yole Korea封装、组装&基板事业部总监&首席分析师Santosh Kumar解释:「预计2.5D/3D硅穿孔(TSV) IC、嵌入式芯片(ED)和扇出型(FO)封装市场的CAGR营收成长最快,市占率分别为21.3%、18%、16%。从数位娱乐、远端工作到数字业务规模的迅速扩展,由于COVID-19带来的新用户行为,塑造出更多数据驱动型产品,更进一步加速导入这些产品的脚步。」
例如:网络、移动、汽车领域的FO;资料中心、人工智能(AI)/机器学习(ML)、CMOS图像传感器(CIS)、高性能运算(HPC)、3D NAND领域中的3D IC堆叠,以及行动和基地台、汽车领域的ED等。
由营收表现角度分析,2019年移动和消费市场,占整体先进封装总营收85%;Yole预估至2025年时,整体市场CAGR,有望达5.5%水准,占整体先进封装市场总营收80%比重。
根据Yole Développement最新调查报告指出,全球「先进封装市场」于2019年至2025年之间,复合平均年成长率(CAGR)为6.6%,预估将带动整体市场营收于此期间,增加达一倍以上。Yole先进封装团队预测,至2025年时,整体市场营收将突破420亿美元,几乎已达传统封装市场预期成长率(2.2%)的三倍之多。
随着台积电进一步扩增「先进封装制程」的产能规模,以满足客户代工需求,同时提高营收实绩。
如此一来,台积电未来进一步增加支出、扩增高阶先进晶圆代工、封装制程产能后,相关「台积电先进封装制程相关供应链」族群股,后市营运可望再获挹注成长动能。
本文来自「理财周刊」,谢谢。
更多关于芯片制造的知识,请搜索“众壹云”
上一篇:下一代的EUV光刻,准备好了吗?

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学