应用材料公司改进了芯片到晶圆和晶圆到晶圆的键合
作者:admin 来源:本站 发布时间:2021-10-13 访问量:1273
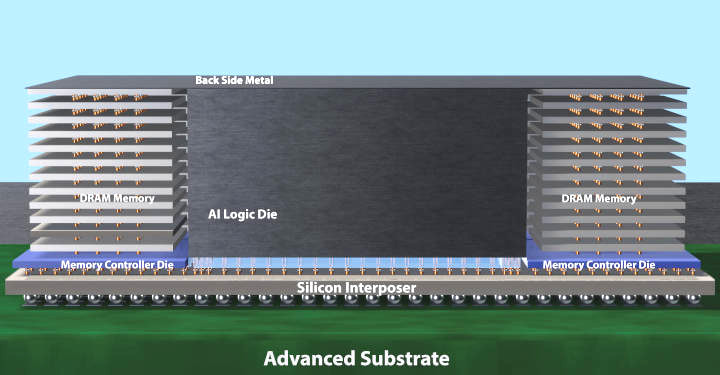
开发是改进了用于芯片到晶圆混合键合的软件建模和仿真 ——它使用直接的铜到铜互连来增加 I/O 密度并缩短小芯片之间的布线长度。
这将允许在硬件开发之前评估和优化材料选择和封装架构等参数,并建立在去年 10 月应用和 BE Semiconductor Industries (Besi) 之间的联合开发协议的基础上,开发基于芯片的混合设备粘合。
Besi 首席技术官 Ruurd Boomsma 表示:“在很短的时间内,Besi 和 Applied 团队在新加坡的混合粘合卓越中心合作取得了巨大进步。” “我们与应用材料公司的合作项目极大地增强了我们对必要的协同优化设备的综合理解。”
对于晶圆对晶圆键合,应用材料公司宣布与 EV Group (EVG) 达成联合开发协议,将应用材料公司在沉积、平面化、注入、计量和检测方面的半导体工艺知识与 EVG 在晶圆键合、晶圆预处理和激活方面的专业知识相结合,以及对齐和键合覆盖计量。
“半导体创新越来越受到 3D 集成和工程材料的推动,这推动了对晶圆到晶圆混合键合的更大需求。优化此流程需要深入了解流程链上下游的集成问题,”EVG 业务开发经理 Thomas Uhrmann 说。“行业合作使我们能够在过程设备公司之间共享数据并学习不同的优势领域。”
应用材料公司还宣布,其最近对 Tango Systems 的收购为面板级处理带来了成果,它为客户提供了来自其显示部门的大面积(例如 500 x 500 毫米)材料技术,包括沉积、电子束测试、计量学和聚焦离子束缺陷分析。

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学