氮化镓功率器件外延技术的发展
作者:admin 来源:半导体芯闻 发布时间:2024-02-22 访问量:2845
氮化镓(GaN)功率器件,例如高电子迁移率晶体管(HEMT),与硅(Si) 功率器件相比具有多项优势。氮化镓的固有材料优势包括具有高临界电场的宽禁带、低固有载流子浓度和高载流子迁移率。器件的优点包括低寄生电容和特定的导通电阻,从而大大改善了功率转换应用中的关键导通和开关损耗品质因数,以及能够在更高的频率下运行,从而缩小了系统尺寸和成本。在本文中,我们将总结一些与氮化镓功率器件外延相关的重要专利申请,这些专利申请可能会将这些优势扩展到更广泛的应用领域。
氮化镓专利监测
技术开发的一个关键部分是通过专利申请来保护知识产权。一项同样重要的补充任务是监控来自竞争对手、研究实验室、大学和个人的专利申请。这可能带来的一些好处包括:
帮助公司及时了解竞争对手的知识产权活动、专利收购和转让,并预测任何新的竞争对手;
新的专利申请可以帮助指导基于对新申请的修改的新解决方案;
防止因专利侵权而引发代价高昂的诉讼;
跟踪过期和放弃的专利有助于识别以前被认为无法使用的开发解决方案;
KnowMade是一家总部位于法国的公司,专门从事科学和专利信息的研究和分析。他们的氮化镓电子专利分析使客户能够获得功率和射频应用领域的最新氮化镓专利格局。图1描述了所提供的一些服务。
在本文中,我们将重点介绍KnowMade在其2023年第三季度氮化镓电子专利监测报告中研究的一家新公司的新专利申请。

图1:KnowMade的专利研究和分析(来源:KnowMade)
GaNcool GaN 外延技术的发展
GaNcool是一家总部位于中国福州和厦门的公司。专注于氮化镓外延的研究、开发和生产。该公司提供的产品包括硅基氮化镓、碳化硅基氮化镓以及蓝宝石基氮化镓。下面我们将讨论他们的一些新专利申请。
蓝宝石衬底上的氮化镓外延
蓝宝石具有高度绝缘、高性价比和透明的特性,使其在GaN LED应用领域得到广泛应用。市售的GaN HEMT功率器件通常限制在650V和更低电压范围内。这些通常使用硅基氮化镓外延制造。扩展到更高的电压(如1,200V)涉及使用更厚的缓冲层,这会增加制造成本和复杂性。蓝宝石的绝缘特性能减少缓冲层中的电场,从而实现更薄的层。1,200V GaN-on-sapphire HEMT已成功演示。使用蓝宝石衬底的一个关键挑战是蓝宝石和氮化镓之间的热膨胀系数存在巨大差异。冷却晶圆外延生长后会产生翘曲、不均匀性、缺陷和裂纹。
专利申请CN116544194旨在解决这个问题。该解决方案涉及在蓝宝石晶圆的背面使用预制的应力调节层,如图2所示。应力和翘曲通过金属-有机化学气相沉积(MOCVD)沉积的GaN层组合来控制。应力控制层与形成HEMT器件的顶部外延GaN层相匹配,以最佳方式控制应力。一种保护性氮化硅(Si3N4) 厚度为5–20nm的薄膜终止这些背面层。应力控制还可以允许使用更薄的基板,从而提高器件的整体热阻。
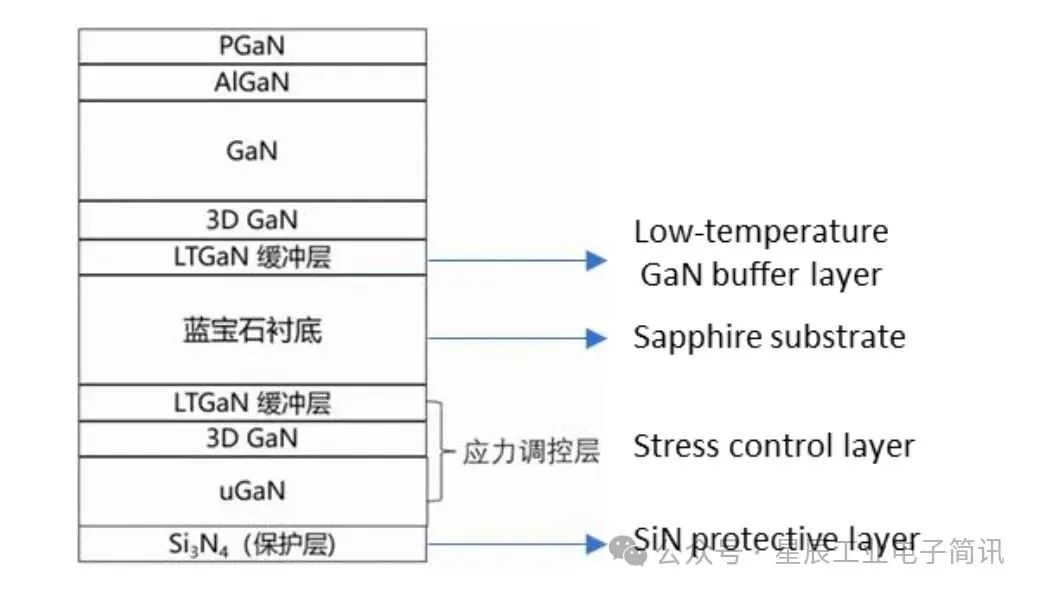
图2:具有应力消除层的蓝宝石上GaN外延(来源:GaNcool专利申请CN116544194)
垂直氮化镓功率器件外延
增加氮化镓功率器件上限电压范围的一种方法是使用垂直器件架构(或vGaN),类似于碳化硅(SiC)中使用的架构。有几个小组正在研究这个主题。均一外延(GaN-on-GaN)法缺乏大型GaN衬底,而这些衬底需要经济高效地用于大批量生产。已经提出了诸如半垂直硅基氮化镓结构等替代方案1。以下专利申请解决了垂直 GaN 功率器件制造中的其它一些关键挑战。
原位掩模钝化层生长
在沟槽蚀刻中,晶圆被硬掩模覆盖,例如:Si3N4,然后将其图案化并用作蚀刻止损层。该掩膜层通常由PECVD沉积。因此,基于MOCVD的GaN外延和掩模沉积是在不同的工具中完成的。潜在的问题可能是在冷却过程中MOCVD室中顶部GaN外延的分解,以及在将晶圆从MOCVD转移到PECVD工具时添加杂质和颗粒。该专利申请CN116825619旨在通过使用原位生长的硅来解决这个问题在MOCVD室中,紧接着要蚀刻的顶部GaN层生长Si3N4。另一个优点是,由于GaN 和Si3N4在高温下生长,它们的热膨胀系数具有良好的匹配性能,从而避免了与应力相关的裂纹。
改善凹槽形成
该专利CN116544105解决了vGaN中形成的蚀刻凹槽产生的损坏,以创建垂直沟槽栅极。通常使用的等离子体蚀刻会在形成栅极电介质的关键表面上造成界面损坏。所提出的解决方案通过氢基反应蚀刻在MOCVD室中原位形成凹槽。蚀刻和生长可以同步进行,蚀刻速率超过生长速率,形成凹槽。可以在MOCVD中进行凹槽处理,以重建内表面,而不会将晶圆暴露在外部环境中。通过这种方式,可以经济高效、可靠地形成无损坏的凹槽。
改进vGaN双极器件中p-GaN/n+氮化镓基极发射极的形成
实现高质量的p掺杂GaN层的问题是有据可查的。通常使用的镁(Mg)掺杂剂是一种相当深的受体,很难完全活化。在活化退火过程中,当p-GaN层被外延层覆盖时,强Mg-H键更难断裂,就像传统的制造方法一样。在专利CN116705607提出的解决方案中,p-GaN层在n-GaN层上经过凹槽蚀刻后原位生长,如图3所示。
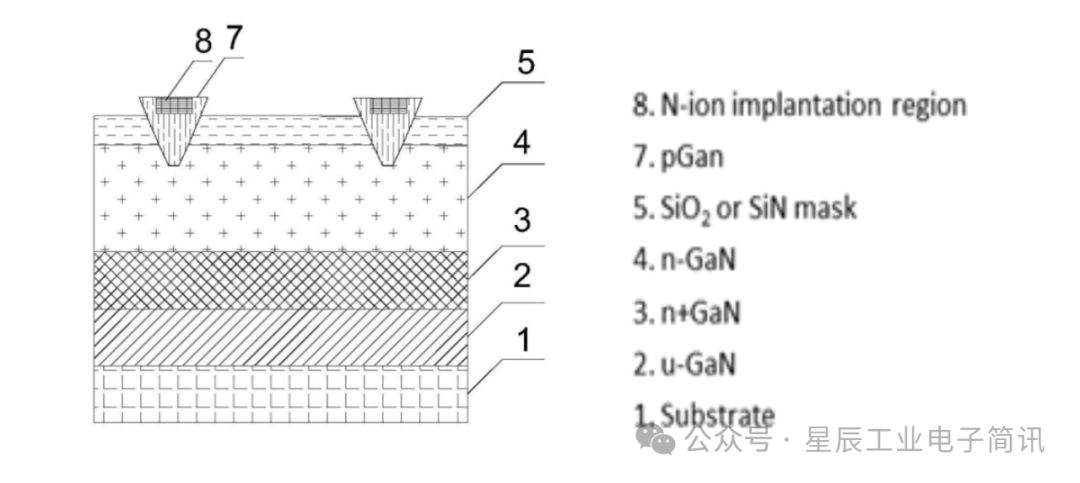
图3:vGaN结构显示了凹槽中p-GaN层的改进形成(来源:GaNcool 专利申请CN116705607)
氮离子(N)注入是在倒梯形p-GaN层的顶面上完成的,然后进行掺杂剂活化退火。根据专利公开,该过程实现了对掺杂剂的活化。另一项可以进一步增强这种结构的专利申请CN 116741810,涉及p-GaN生长,以横向伸出凹槽。然后,在此基础上形成蘑菇顶部形状的n+ GaN(发射极)层,从而有效地增加了 n/p结的表面积并减少了电流拥挤。

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学