半导体的化学机械研磨抛光CMP技术
作者:admin 来源:中国科学院半导体研究所 发布时间:2024-02-21 访问量:1368
本文介绍了半导体研磨方法中的化学机械研磨抛光CMP技术。
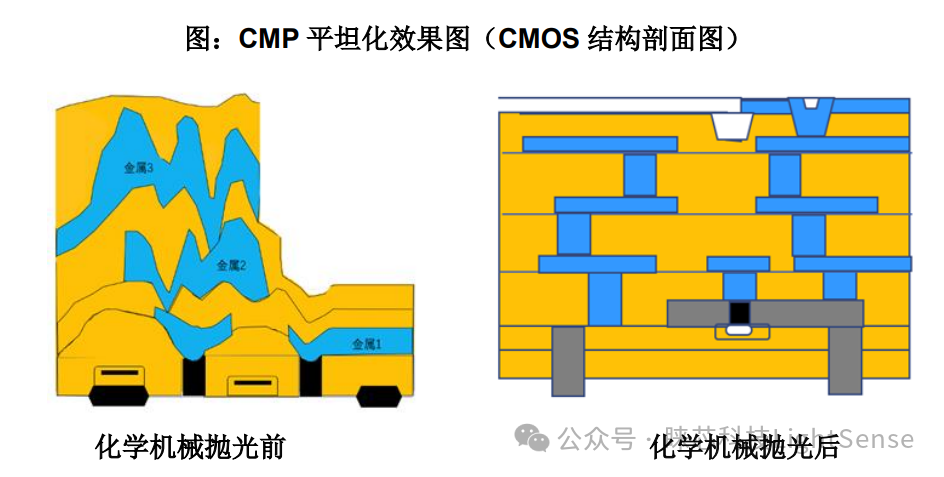
随着线宽越来越小、层数越来越多,对 CMP 的技术要求越来越高,CMP 设备的使用频率也越来越高,在先进制程集成电路的生产过程中每一片晶圆都会 经历几十道的 CMP 工艺步骤。
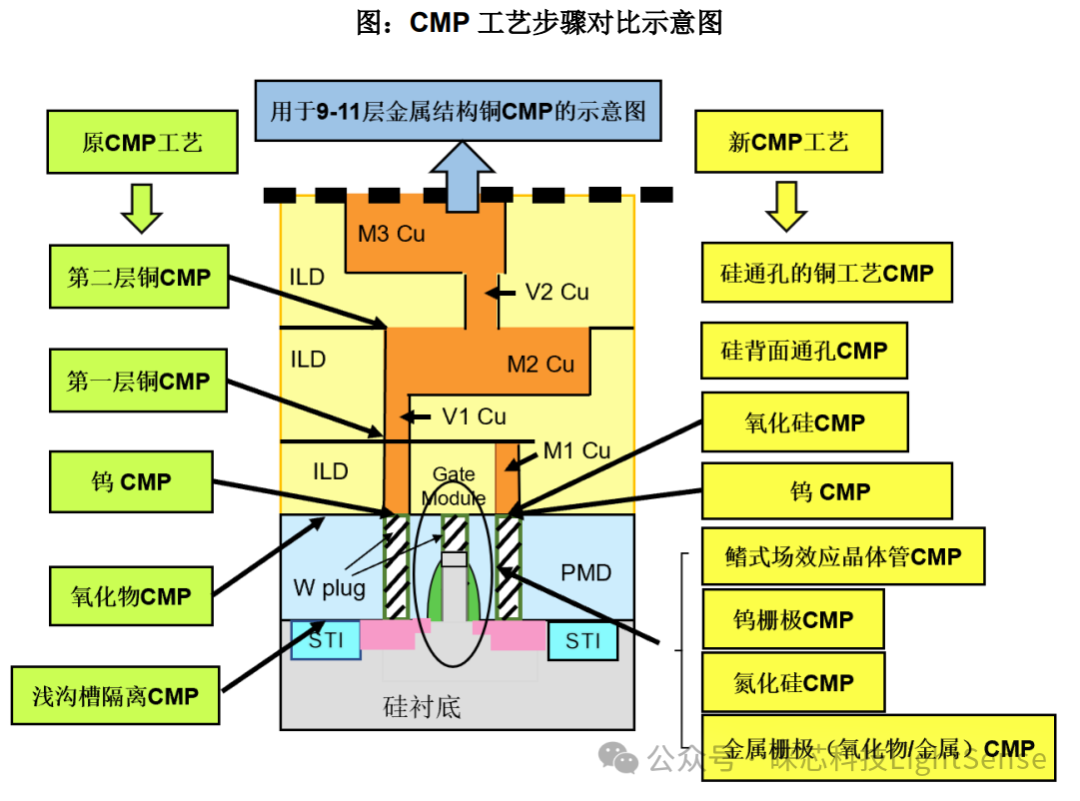
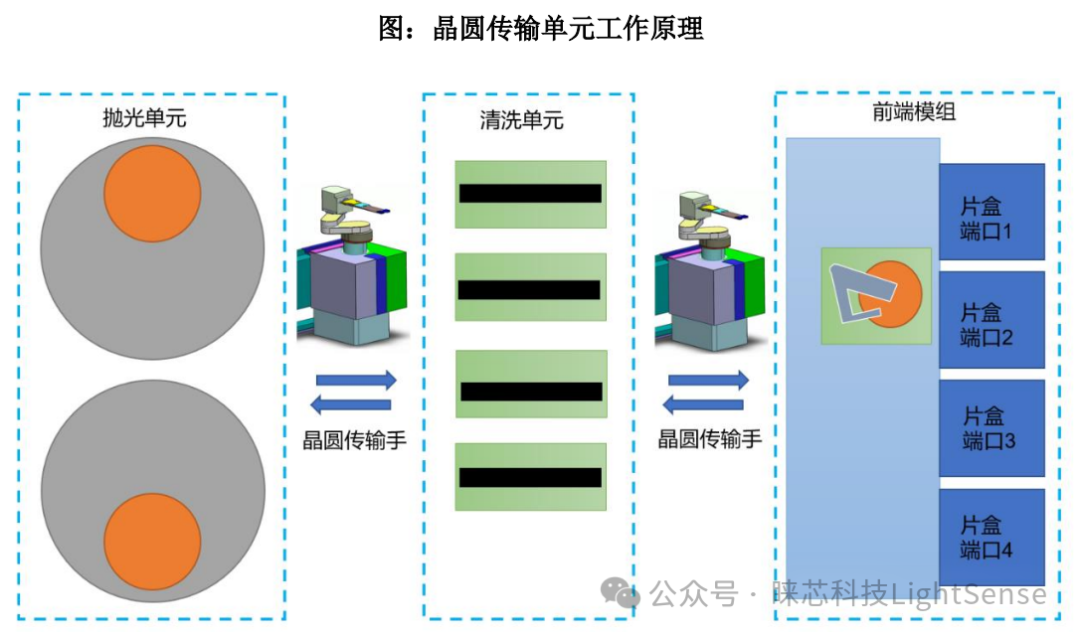
B)光单元在抛光单元中,利用化学腐蚀与机械研磨的协同配合,通过夹持晶圆的研磨头和研磨垫之间的相对运动来实现晶圆表面平坦化。在研磨垫和晶圆之间滴入一 定流量的研磨液,利用研磨液中的化学成分产生的腐蚀作用,以及研磨液颗粒产生的机械摩擦力去除晶圆表面的多余材料,实现晶圆全局平坦化。
抛光过程中通 过研磨头的不同区域同时施加不同压力来调整区域研磨速率,从而优化晶圆表面的全局平坦化程度。同时,运用终点检测技术,实时检测晶圆表面的材料厚度, 在达到预定厚度后停止抛光。
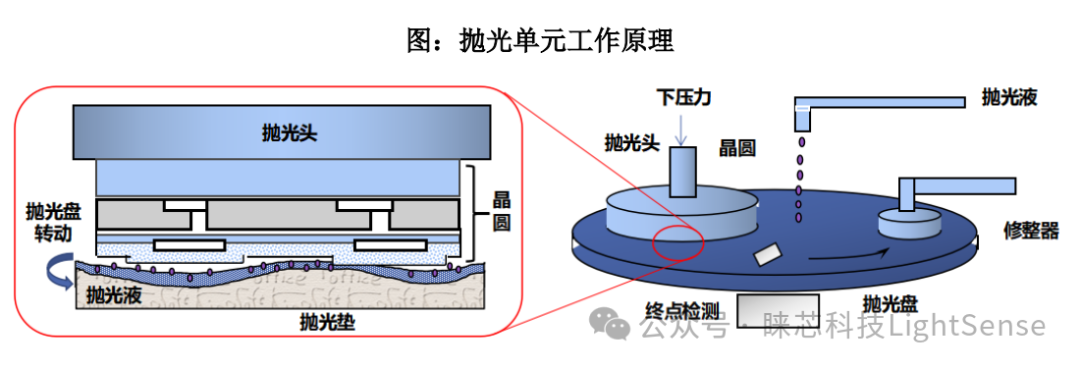
C)清洗单元在完成化学机械抛光后,通过清洗单元有效去除晶圆表面的颗粒污染物,并干燥晶圆。清洗单元一般包含兆声清洗模组、刷洗模组及干燥模组等。兆声清洗模组利用兆声波能量及化学液的腐蚀作用实现大颗粒的去除。刷洗模组利用清洗化学品的腐蚀和机械刷洗双重作用去除晶圆表面的强附着力颗粒,并用超纯水冲洗残留的沾污。干燥模组通过高速旋转产生的离心力,异丙醇溶剂产生的马兰戈尼效应去除晶圆表面的水渍,实现晶圆干燥。

上一篇:逻辑芯片,还能微缩吗?
下一篇:氮化镓功率器件外延技术的发展

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学