晶圆级封装结构的分析
作者:admin 来源:Tom聊芯片智造 作者Tom 发布时间:2024-04-16 访问量:1064
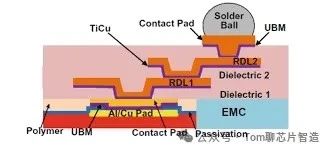
EMC (Epoxy Molding Compound):环氧树脂封装材料,用于保护半导体芯片免受物理损伤和环境因素影响,这里是起到支撑作用。
Dielectric Layers:电介质层(如Dielectric 1和Dielectric 2)用于绝缘不同的导电层,一般是PI胶来充当,防止电气短路,并提供机械支撑。
RDL :重分布层用于重新布线芯片上的电路,使之与外部连接点匹配。RDL可以有多个层次(如RDL1和RDL2),以实现复杂的电路重布线。
UBM :同Ti/Cu Layer层,主要是晶圆导电的作用。
Solder Ball:锡球,为了电子封装中的电气连接,用于芯片与电路板之间的互连。
TiCu Layer:电镀种子层,便于电镀工序的进行
Al/Cu Pad:芯片的Al或Cu电极。
Contact Pad:电镀金属层,可能为Cu,Ni,Pd,Au等
Passivation Layer:钝化层通常是由氮化硅或氧化硅制成的,用于保护半导体表面免受外界环境的侵害,如化学污染或湿气。
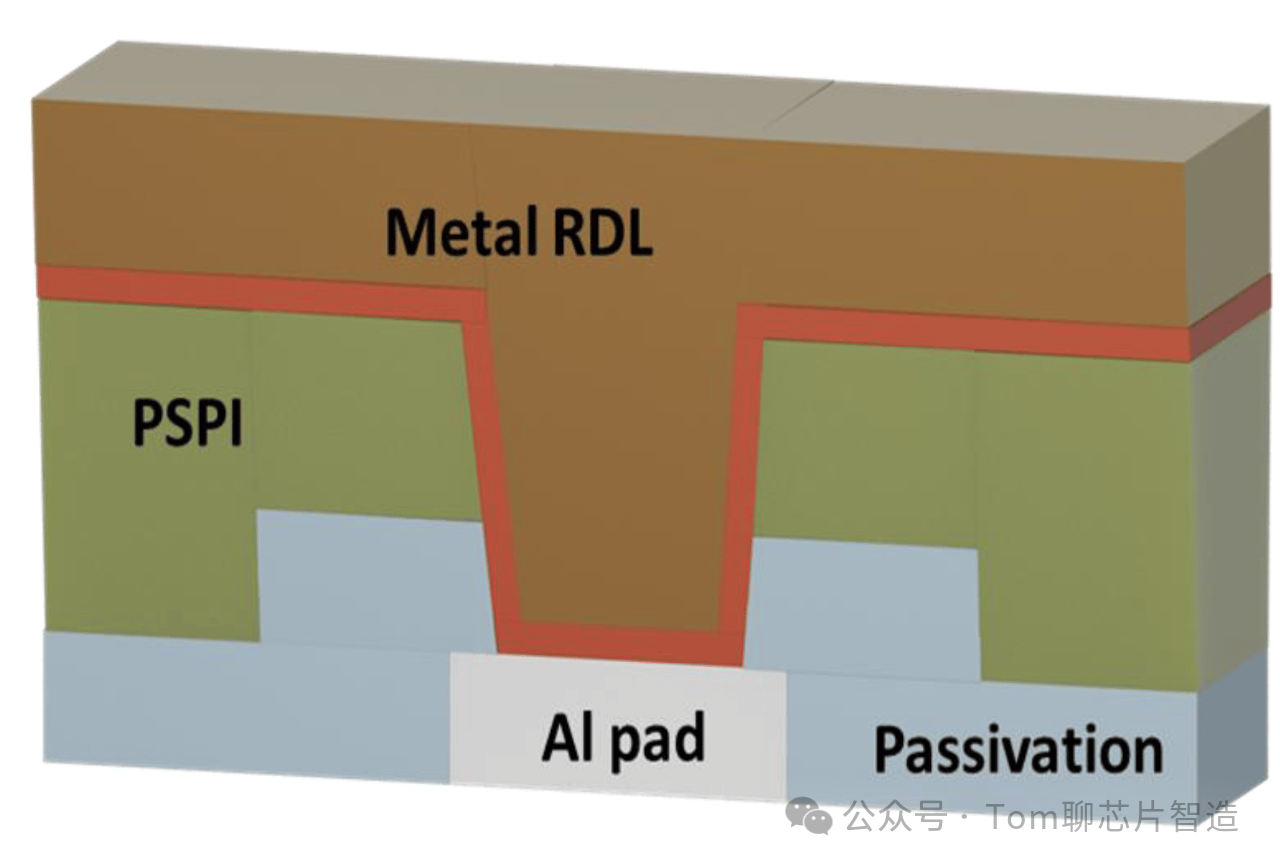
上一篇:半导体工艺设备:晶圆片制造
下一篇:全球首颗可编程的光芯片

 上海市智能制造产业协会
上海市智能制造产业协会 上海市集成电路行业协会
上海市集成电路行业协会 华东理工大学
华东理工大学